 Спектральные эллипсометры и рефлектометры от Angstrom Sun Technologies.
Спектральные эллипсометры и рефлектометры от Angstrom Sun Technologies.
При изучении материалов методом эллипсометрии на поверхность падает монохроматический плоскополяризованный свет, который после отражения и преломления приобретает эллиптическую поляризацию вследствие наличия тонкого переходного слоя на границе раздела сред. Зависимость между оптическими постоянными слоя и параметрами эллиптически поляризованного света устанавливается на основании формул Френеля. На принципах эллипсометрии построены методы чувствительных бесконтактных исследований поверхности жидкости или твердых веществ, процессов абсорбции, коррозии и пр.
Компания Angstrom Sun Technologies (AST) является известным во всем мире производителем оптических решений для характеризации тонких пленок. Среди них доступные по цене, но передовые и высокоэффективные инструменты, такие как спектральные рефлектометры, микроспектрофотометры, микрорефлектометры, системы картирования толщины пленок, просты настольные измерители толщин пленок, автоматизированные спектральные эллипсометры с варьируемым углом. Также, AST предоставляет сервис по измерению пленок.
Эллипсометры Angstrom Sun Technologies успешно используются в лабораториях: NASA Marshall Space Flight Center, National Institute of Standards and Technology, Massachusetts Institute of Technology (MIT), Seoul National University, NanoTech Center (CESTM) в SUNY, Columbia University, Hewlett-Packard Co., Lockheed Martin Co., General Electric (GE), Corning Inc., Bell Laboratories, Johnson-Johnson, Mylan Technologies, Applied Materials (AMAT), Lam Research, Samsung Advanced Institute of Technology(SAIT), и MIT Lincoln Laboratory и многих других.
Все модели делятся по признаку диапазона длин волн. Ниже краткое описание. Кроме того, модели серии 500 покрывают интервалы от 100 и 400. Возможна кастомизация в зависимости от решаемых задач: расширение диапазона длин волн в область глубокого УФ или ИК.
- Серия 100 покрывает диапазон длин волн от глубокого УФ до ближнего ИК, вплоть до 1100 нм
- Серия 200 покрывает глубокий УФ и видимый диапазоны
- Серия 300 покрывает видимый диапазон, начиная от 370 нм и до 850 нм
- Серия 400 покрывает ближний ИК, начиная от 900 нм
- Серия 450 покрывает интервал от видимого до ближнего ИК, начиная от 370 нм и до 1700 нм
- Серия 500 покрывает диапазон от глубокого УФ до ближнего ИК, вплоть до 2500 нм
- Серия 600 покрывает интервал от ближнего ИК до ИК (1.7 — 17 мкм или 1.7 — 30 мкм)
Модели приборов:


 Спектроскопический рефлектометр SR500
Спектроскопический рефлектометр SR500

 Спектроскопический эллипсометр SE200BA-MSP
Спектроскопический эллипсометр SE200BA-MSP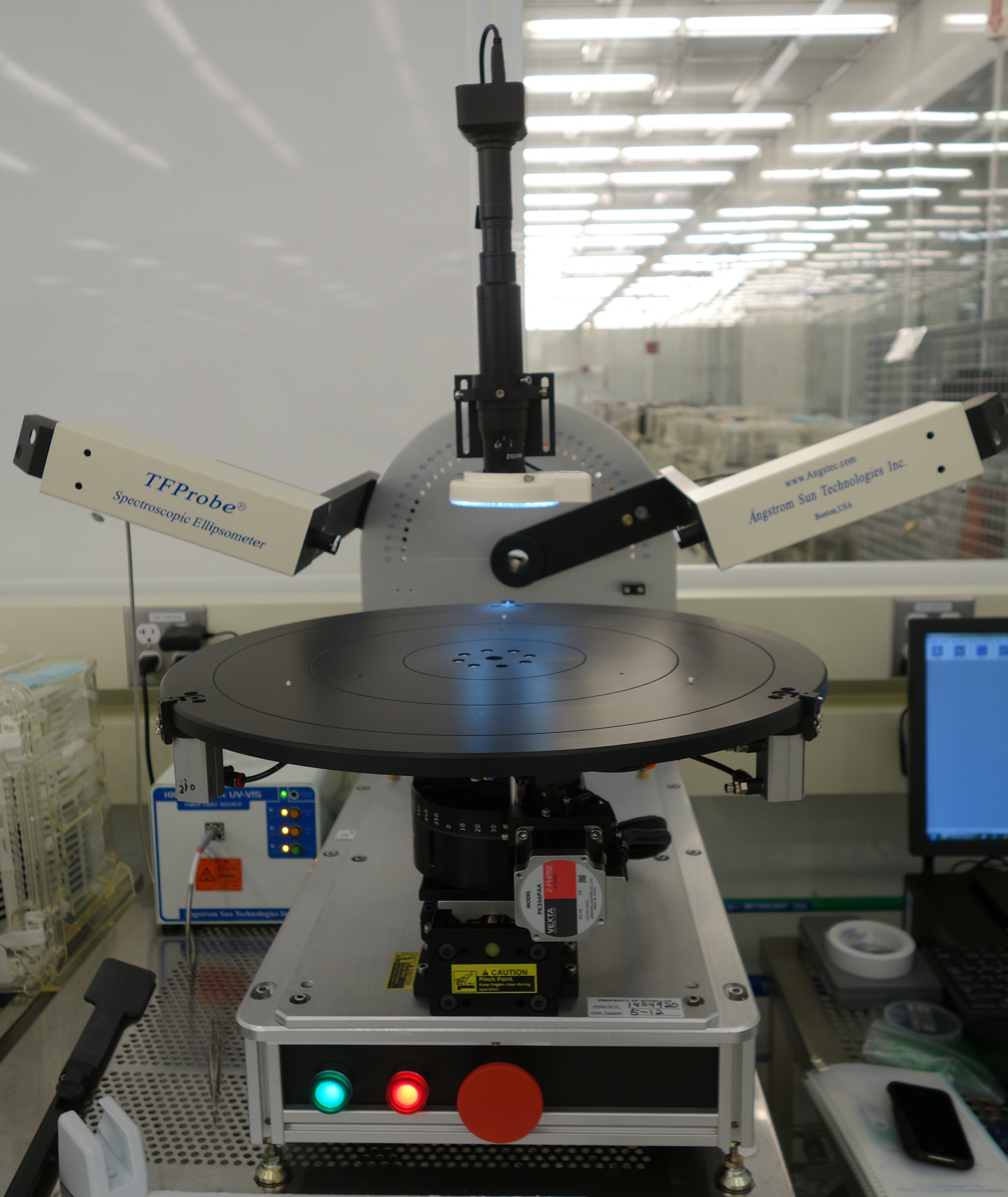
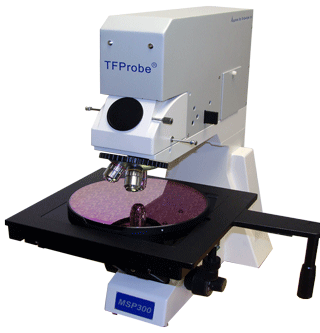 Микроспектрофотометр MSP300
Микроспектрофотометр MSP300 Устройство для картирования толщины пленки SRM300
Устройство для картирования толщины пленки SRM300